12단 HBM 이어 16·20단 차세대 HBM 준비
이르면 9월 엔비디아에 12단 HBM3E 공급
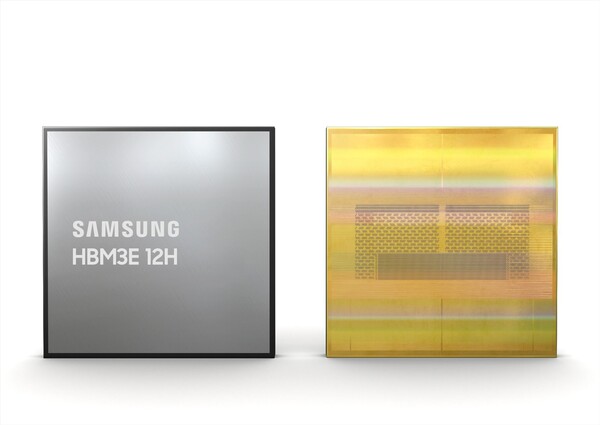
[데일리한국 김언한 기자] 삼성전자가 고대역폭메모리(HBM)에서 고용량 제품으로 승부수를 띄운다. D램을 12단(36GB)으로 쌓은 HBM3E(5세대 HBM) 공급에 속도를 낼 계획이다.
29일 업계에 따르면 삼성전자는 이르면 오는 9월부터 엔비디아에 12단 HBM3E를 공급할 것으로 예상된다. 일각에선 삼성전자가 이 제품을 독점 공급할 가능성도 거론하고 있다.
경쟁업체인 SK하이닉스는 D램을 8단(24GB)으로 쌓은 HBM3E를 최근 양산하기 시작했다. 이 회사는 최근 진행된 엔비디아의 연례 개발자 컨퍼런스 'GTC2024'에서 HBM3E 12단 제품을 선보였지만 공급 시점은 알려지지 않았다.
HBM은 D램 여러 개를 수직으로 연결해 데이터처리 속도를 혁신적으로 끌어올린 메모리반도체로, 챗GPT 등 생성형 인공지능(AI)을 구현하는 핵심이다. D램을 많이 쌓을수록 고용량이 되기 때문에 가격이 비싸고 수익성도 높다.
현재 전체 HBM에서 수요가 가장 많은 것은 4단 제품인 것으로 파악된다. HBM은 엔비디아에 공급되는 고용량 제품 수익성이 가장 높지만 상대적으로 용량이 적은 제품의 수요도 상당하다.
삼성전자는 엔비디아 AI 가속기용 HBM 공급망 진입에 고배를 마시면서 D램을 4단으로 쌓은 HBM을 중심으로 시장을 공략했다. 반면 SK하이닉스는 엔비디아에 8단 HBM3를 독점 공급해 지난해 수익성 개선 속도가 삼성전자의 반도체 사업보다 훨씬 빨랐다.

삼성전자는 엔비디아에 12단 HBM3E 공급을 시작으로 고용량 제품의 경쟁력을 확보하는 데 힘을 실을 것으로 전망된다. 특히 16단 HBM4부터는 하이브리드 본딩(칩과 칩을 연결하는 범프를 없애는 적층 기술)을 적용할 것이란 관측이 우세하다.
이 기술을 사용하면 쌓는 칩의 수를 늘리면서 전체 칩의 두께 제약 문제를 극복할 수 있다. HBM4는 오는 2026년 시장에 등장할 것으로 예상된다.
업계 관계자는 "16단 HBM부터는 삼성전자와 SK하이닉스 모두 하이브리드 본딩이 필요하기 때문에 여기서 또 한 번 지각변동이 나타날 수 있다"고 말했다.
삼성전자는 D램을 20단으로 쌓은 HBM도 준비하고 있는 것으로 알려졌다. 오는 2028~2029년 HBM4E 또는 HBM5부터 20단 제품이 등장할 전망이다.
삼성전자가 12단 HBM3E 공급을 본격 시작하면 SK하이닉스와의 격차를 좁힐 수 있다. 또 HBM4E 공급을 시작으로 HBM3를 엔비디아에 넣는 상황을 기대할 수 있다.
시장에선 지난해 SK하이닉스의 전 세계 HBM 점유율을 60% 중반대로 보고 있다. 삼성전자는 30% 중반대의 점유율을, 나머지는 미국의 마이크론이 가져간 것으로 추정된다.


